
掃碼添加微信���,獲取更多半導(dǎo)體相關(guān)資料
引言
? ? ? 電子工業(yè)中用于集成電路的典型硅片是由直拉法生長(zhǎng)的硅單晶錠切割而成的�。這種單晶是從石英坩堝中的熔體中拉出的,該坩堝將氧原子結(jié)合到硅晶體中�����。氧原子占據(jù)硅晶格中的間隙位置����,并能形成二氧化硅團(tuán)簇的核。這種硅晶體的熱處理引起氧擴(kuò)散和氧沉淀物的生長(zhǎng)�。晶體生長(zhǎng)過(guò)程中每個(gè)晶片的熱歷史負(fù)責(zé)晶體不同部分中間隙氧和氧化物核的各種分布��。本文研究了不同溫度工藝后直拉硅單晶中的氧沉淀��,研究了不同溫度預(yù)退火對(duì)氧沉淀的影響����,其中溫度歷史沒(méi)有完全消除�����,只是達(dá)到了不同的抑制階段。通過(guò)紅外(IR)吸收光譜測(cè)量使用不同溫度和時(shí)間的沒(méi)有和具有TR預(yù)退火的樣品�,并將結(jié)果與化學(xué)蝕刻和透射電子顯微鏡(TEM)進(jìn)行比較�����。本文還討論了從錠頭和錠尾觀(guān)察到的晶片溫度歷史的影響�。
?
實(shí)驗(yàn)
? ? ? 我們探討了從兩個(gè)1.5毫米厚的硅晶片上切下的樣品中氧的沉淀過(guò)程。一個(gè)樣本是靠近直徑為150毫米的直拉法生長(zhǎng)晶錠的起點(diǎn){S}和另一個(gè)靠近終點(diǎn){E}切片���。該晶錠摻硼,電阻率為3-5Ω·cm���,晶片表面的晶體取向?yàn)椋?11)����。
? ? ? 兩個(gè)晶片{S�,E}被一起分成10個(gè)系列的矩形樣品(尺寸約為20 mm × 15 mm):五個(gè)系列的樣品來(lái)自錠頭{S}��,另外五個(gè)系列的樣品來(lái)自錠尾{E}。每個(gè)系列進(jìn)行各種TR退火:TR 1和TR 2–分別在1000℃和1100℃下退火6分鐘�����,TR 3和TR 4–在與TR 1和TR 2相同的溫度下退火24分鐘����,加上一個(gè)標(biāo)為R的系列作為參考���,沒(méi)有TR過(guò)程。在下一步中����,使用以下三步處理對(duì)所有樣品進(jìn)行退火:600℃退火8小時(shí)(成核)��,800℃退火4小時(shí)(均化)和1000℃退火不同時(shí)間t(沉淀)�。每個(gè)系列包含幾個(gè)具有合適的沉淀時(shí)間t范圍的樣品。選擇時(shí)間t�����,使得間隙氧的衰減在溫度1000℃下很好地向平衡氧濃度ceq收斂�����。由于實(shí)驗(yàn)的目的是研究TR對(duì)降水的逐漸影響����,只是部分消除了熱歷史���,所以我們使用1000℃和1100℃的預(yù)退火溫度來(lái)代替其他工作中使用的RTA�����。兩種晶圓通用的熱處理概述如表1所示�����。
? ? ? 所有樣品的溫度處理都是在傳統(tǒng)的實(shí)驗(yàn)室爐中使用氮?dú)饬鞔髿庵羞M(jìn)行的�����。晶片在退火前進(jìn)行化學(xué)拋光�,以消除樣品邊界上滑動(dòng)錯(cuò)位的產(chǎn)生�����。通常在退火前后通過(guò)化學(xué)清洗去除20mm厚的表層����。
 ?
?
表1 對(duì)兩個(gè)樣品系列進(jìn)行熱處理:從鑄錠開(kāi)始{S}和從鑄錠結(jié)束{E}
?
結(jié)果和討論
? ? ? 文中給出了透射光譜的測(cè)量結(jié)果�,以便獲得二氧化硅沉淀的純吸收光譜。通過(guò)減去含有最少量間隙氧(8.6×1015cm-3)的浮動(dòng)區(qū)硅譜��,從硅譜中去除了多聲子吸收帶�。為了區(qū)分間隙氧和氧沉淀的貢獻(xiàn),將在77 K下測(cè)量的退火樣品的光譜與在生長(zhǎng)的參考樣品上測(cè)量的光譜進(jìn)行了比較�����。
? ? ? 根據(jù)前文所述的理論,由橢球體沉淀的長(zhǎng)徑比雙驅(qū)動(dòng)的變化去極化因子Li控制了吸收光譜中最高最大值對(duì)應(yīng)的吸收帶的位置����。球形二氧化硅沉淀的最大值略低于1100cm-1���,而二氧化硅圓盤(pán)沉淀的最大值約為1250cm-1��。對(duì)于橢球體的氧氣����,根據(jù)長(zhǎng)寬比沉淀最大位移。
? ? ? 圖1和圖2根據(jù)中描述的模型擬合��,還顯示吸收系數(shù)光譜的模擬結(jié)果中使用三種不同長(zhǎng)寬比的沉淀物�。更多不同的類(lèi)型會(huì)導(dǎo)致更好的擬合�����,但是擬合模型的條件會(huì)更少����。由于在測(cè)量的光譜中可以清楚地觀(guān)察到三個(gè)吸收帶���,我們將模型限制為三種不同的類(lèi)型——長(zhǎng)寬比����,其中每種類(lèi)型也可以具有不同的體積分?jǐn)?shù)和化學(xué)計(jì)量比�。因此,沉淀物由三種共存的稀釋二氧化硅橢圓體表示�,它們具有三種不同的縱橫比bi和體積分?jǐn)?shù)fi�����。從擬合吸收光譜獲得的二氧化硅x3圓盤(pán)的化學(xué)計(jì)量演化與測(cè)量值的比較如圖3所示,對(duì)于來(lái)自?xún)蓚€(gè)晶片的所有樣品���。結(jié)果表明����,在接近晶錠開(kāi)始的晶片中出現(xiàn)了片狀沉淀物�����。
?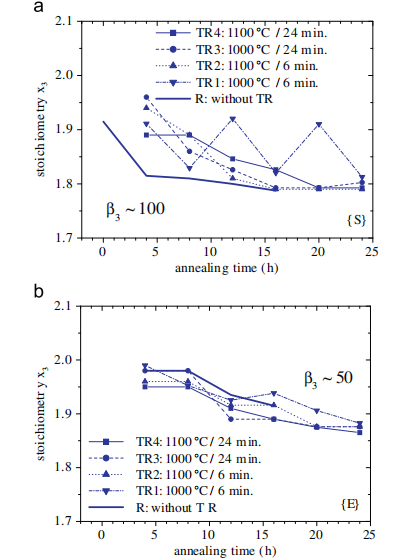
圖3 對(duì)于不同預(yù)熱的樣品組�,繪制了板狀沉淀物(縱橫比cca 50和100)中氧的化學(xué)計(jì)量的演變
? ? ? 二氧化硅橢偏體的稀釋溶液模型也允許我們確定由吸收光譜強(qiáng)度確定的特定類(lèi)型沉淀物的體積分?jǐn)?shù)fi��,見(jiàn)等式�。從所有三種假設(shè)類(lèi)型的橢球體的體積分?jǐn)?shù)f獲得的沉淀物內(nèi)部氧濃度的增加如圖5所示���。此外,沉淀氧總濃度的演變����,如圖最左圖5所示����,表明1000℃6min時(shí)TR過(guò)程的沉淀受到明顯抑制��,而1100℃24min時(shí)的TR導(dǎo)致氧沉淀更類(lèi)似于沒(méi)有TR的參考樣品��。這種沉淀生長(zhǎng)的延遲趨勢(shì)在所有假設(shè)類(lèi)型的沉淀中都是明顯的�。另外����,在靠近鋼錠開(kāi)始的晶片中����,板樣沉淀在最長(zhǎng)退火時(shí)達(dá)到長(zhǎng)寬比,而TR處理過(guò)的樣品并非如此�����。在接近鋼錠末端的地方����,預(yù)退火和未預(yù)退火的樣品之間的晶圓片的差異并不顯著,因?yàn)樵谶@種情況下�����,溫度歷史要短得多。
?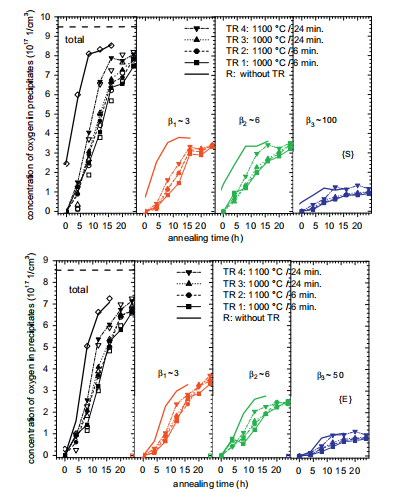
圖5 根據(jù)不同預(yù)熱樣品組的紅外光譜確定沉淀物內(nèi)部氧含量的增長(zhǎng)
? ? ? 從鑄錠的開(kāi)始和結(jié)束開(kāi)始,在晶片中采用四種不同的TR過(guò)程實(shí)現(xiàn)了溫度預(yù)退火對(duì)沉淀的影響���。退火過(guò)程中間氧損失值和氧沉淀擬合譜的參數(shù)對(duì)預(yù)退火具有顯著的敏感性����。在沉淀過(guò)程中�����,我們觀(guān)察到在標(biāo)準(zhǔn)熱處理前使用較低的溫度和較短的TR�����,在沉淀退火過(guò)程中����,Oi的衰減速度較慢。在沒(méi)有TR工藝的晶圓中�,1000℃12h后氧氣已經(jīng)完全沉淀�,但最短的TR工藝至少延長(zhǎng)沉淀兩次,見(jiàn)Ref中接近錠種子的晶圓的結(jié)果�����。
?
總結(jié)?
? ? ? 在本文中����,我們研究了在籽晶處和晶錠端部切片的直拉硅片中的氧沉淀�����,這些硅片通過(guò)各種熱處理和各種高溫預(yù)熱進(jìn)行處理���。從紅外透射光譜我們了解到沉淀物的形態(tài)已經(jīng)在成核和穩(wěn)定化退火過(guò)程中形成���,而化學(xué)計(jì)量仍然在板狀團(tuán)簇的沉淀過(guò)程中演變。球形二氧化硅沉淀的化學(xué)計(jì)量變化低于檢測(cè)限���。高溫預(yù)退火的效果影響所有的沉淀物���,這些沉淀物的體積分?jǐn)?shù)隨著預(yù)退火溫度的降低而降低�。這種效應(yīng)在來(lái)自晶錠籽晶的晶片中更明顯,在晶錠籽晶中�����,晶片的溫度歷史比接近晶錠末端的晶片更顯著�����。由于吸收光譜對(duì)盤(pán)狀沉淀物的敏感性增加�,我們能夠更好地觀(guān)察到板狀沉淀物的化學(xué)計(jì)量和縱橫比的變化,而不是球狀沉淀物的變化���。