
掃碼添加微信����,獲取更多半導體相關資料
本文研究了兆頻超聲波輸入功率��、溶液化學、浴溫和浸泡時間的影響�,在高兆頻超聲波輸入功率和中高溫下進行的充分稀釋的化學反應被證明對小顆粒再利用非常有效����,浴組成數(shù)據(jù)顯示���,當在中等溫度(例如45℃)下使用高純度化學品時�,可以獲得延長的壽命,過渡金屬表面濃度和表面粗糙度已經(jīng)在稀釋的SC-1處理后進行了測量,并與傳統(tǒng)SC-1處理后的金屬污染進行了比較��。
在低功率下����,清洗效率隨溫度的升高而迅速變化���,但在高功率下,清洗效率與溫度無關��,在確定的實驗空間內�,化學比對粒子去除只有中等的影響(見下圖),驗證性實驗是在實驗空間內進行的���,這樣之前的運行就不會被重復。
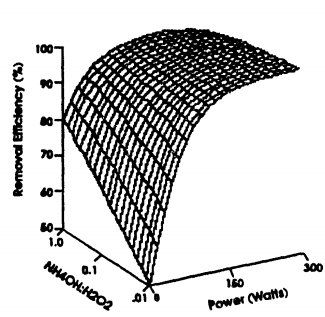
實驗工作表明,大量稀釋的SC-1化學物質可能會非常有效地去除亞于0.15_m的顆粒��,此外還注意到清潔效率是氫氧化銨與過氧化氫比值的函數(shù),由于化學比例影響清洗效率��,有必要確定在稀釋的化學浴中可以保持高清洗效率的壽命�,用1:10:130(NI-HOH:H20_:H20)SC-I進行實驗�,至45°C,浴缸在溫度下保持了7個小時,在此期間��,對污染了硝化硅的晶片進行了清洗和測量���,以提高顆粒去除效率。
使用稀釋化學清洗腐蝕劑已被證明等于或優(yōu)于標準化學清洗,由于用水量是濕臺擁有成本的重要一部分�����,因此比較稀釋清潔劑的沖洗時間與標準化化學的對比是很有趣的��,將完整的晶片浸入SC-I溶解液中,并在級溢出浴中沖洗��,記錄了不同清潔溶液達到15毫里厘米的時間,這些實驗總共重復了5次���。
表面表征測量采用固體化學清潔(45°C���,200W功率下1:10:130)和標準SC-1清潔(65°C,200W功率下1:1:5)進行比較�,根據(jù)TXRF和AFM分析,AFM數(shù)據(jù)報告精確到:1:0.05A�,重金屬污染的重離子背散射光譜(HIBS)�,表面粗糙度的能量散散x射線反射率(EDXRR)���,這些數(shù)據(jù)證實了TXRF和AFM的測量結果,顯然���,稀釋化學清潔中較少的表面粗糙����,而較少的化學暴露導致金屬表面污染較低��。
本研究結果表明�,具有足夠大能量的稀釋劑化學物質可以非常有效地去除小(<0.15_tm)無機顆粒,現(xiàn)有技術(浸入式超氣體)應用于未來再生裝置的制造��,此外�,使用稀釋的、高純度的化學品將減少化學品和沖洗水的使用,從而降低擁有成本����,由于這些結果強烈依賴于超大型輸入力�,因此結果也可能非常依賴于工具�����,還發(fā)現(xiàn)顆粒組成和形貌影響清洗結果�����。